原子层沉积系统 ALD (Atomic Layer Deposition)
热式原子层沉积系统 (Thermal ALD)

基本技术参数
基片尺寸: 4 -12 英寸可选
样品高度: 6 mm, 可选配更高样品选件
基片温度: RT-400℃,控制精度±1℃,可选配更高温度选件
前驱体输运系统: 标准2路前驱体管路,可以选配到6路以上
载气系统: N2或者Ar
沉积模式: 连续模式TM(FlowTM)、停流模式TM(StopFlowTM)、压力调谐模式TM(PreTuneTM)
可选件: 手套箱,大尺寸/多片样品夹具,颗粒包裹夹具,臭氧发生器,原位监测系统,尾气处理系统,客户定制反应腔等
沉积均匀性: Al2O3 均匀性 <+/−1%
电源: 50-60Hz, 220V /15A交流电源 ,标准金属机柜,易拆卸柜板,可调节支脚
仪器尺寸: 1100 X 600 X 1200 mm
等离子体增强原子层沉积系统 (PEALD, Plasma Enhanced ALD)
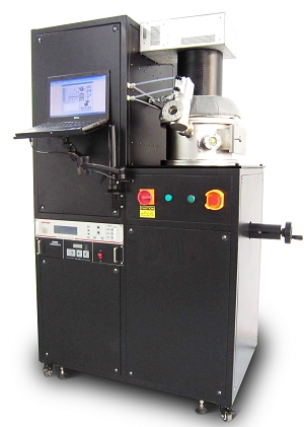
基本技术参数:
基片尺寸: 4,8,12 英寸可选
基片温度: RT-600℃,控制精度±1℃,可选配更高温度选件
前驱体输运系统: 标准3路前驱体管路,可以选配到6路以上
反应腔: 喷淋式等离子体和前驱体进气口,铝制穹顶等离子体扩散腔
沉积模式: 热沉积模式、等离子增强模式、连续模式TM(FlowTM)、压力调谐模式TM(PreTuneTM)、单面沉积模式TM(SingleProTM)、离子束辅助沉积模式, 以上可选
等离子体气源: 标准3路,可以选配到6路以上
等离子体源: ICP remote plasma 500W, 更大功率可选
基片输运系统: 手动, 手动/自动Load lock可选
可选件: 手套箱,臭氧发生器,原位监测系统,尾气处理系统,单面沉积模式附件, 离子束辅助沉积模式附件
沉积均匀性: Al2O3 均匀性 <±1%
仪器尺寸:1250(L)X800(W)X1800(H) mm
卷对卷原子层沉积系统(Roll to Roll ALD)
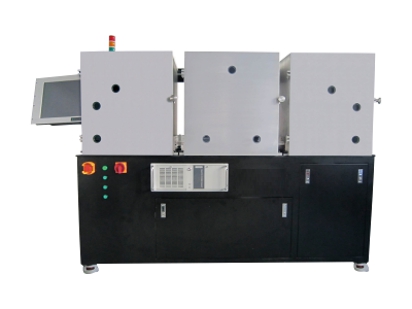
基本技术参数:
专门为柔性材料沉积领域的用户设计的原子层沉积系统。是基于革命性的创新设计的高产能卷对卷原子层沉积系统,模块化的沉积单元可灵活配置组合以适用于不同的走带速度和基带宽度。该系统完全符合CE标准。它的操作界面直观简单,配备多种材料的标准沉积工艺配方,使用及维护成本低。
高度集成和灵活性使该系统适用于不同幅宽的柔性薄膜材料(典型材料PEN、PET)。50μm厚度基带可以一次完成1000m以上沉积。提供不同厚度沉积模块供用户选择。设备高度集成体积2m(长)X1m(宽)X1.6m(高)。
精确控制与多种沉积模式,包括单向沉积模式、往复沉积模式、单面沉积模式、双面沉积模式等。可实现高速单、双面沉积,以及较厚(>50nm)的薄膜沉积。
稳定可靠与低使用维护成本。腔体采用真空系统,结合特殊的前驱体气路设计,把前驱体源和载气的浪费减少到最低。典型Al2O3沉积工艺:N2载气流量1000sccm;每小时TMA消耗量<1g;实际使用功率:5KW。
完美的易操作性。操作界面直观简单, 操作者很容易熟练掌握。所有参数(包括前驱体剩余量、沉积温度、载气流量,阀门状态等)均在操作界面中显示、设定、修改。整个沉积过程及状态参数均实时显示。
完善的安全保障包含多重安全保护机制:阀门状态报警、温度超限报警、前驱体源不足报警等。异常情况自动关闭阀门、加热电源、电机等设备防止损伤以及前驱体泄漏。
工业量产及特殊定制原子层沉积系统
可提供针对工业量产的工业级原子层沉积系统,包括标准系统和特殊定制系统。
专门为工业化生产而设计的全自动原子层沉积系统, 采用了独特的前驱体输运方式,可以完美地实现薄膜厚度与薄膜厚度均匀性的精确控制。配备多种材料的标准沉积工艺配方,满足工业应用的标准, 使用及维护成本低。
同时可专门为科学研究与工业用户定制所要求的特殊原子层沉积系统, 包括与各种其他设备的无缝连接,样品的传输检测,特殊沉积工艺要求, 等等。
详细信息请联系我们 !